MueTec provides in addition to the worldwide well established optical CD (Critical Dimension) mask metrology a cost effective and fast mask defect inspection method to capture statistical defects. Our systems are used in wafer manufacturing, photomask manufacturing, MEMS and LED manufacturing and in research institutes.
SIGNIFICANT ADVANTAGES
- Cost effective solution for statistical defecs
- VIS capability
- Reflected and transmitted light
- High quality objectives
- Flexible tool configurations available (manual to fully automized mask handling)
- Bare mask and pellicle inspection
- Universal use, in addition to inspection also CD-metrology
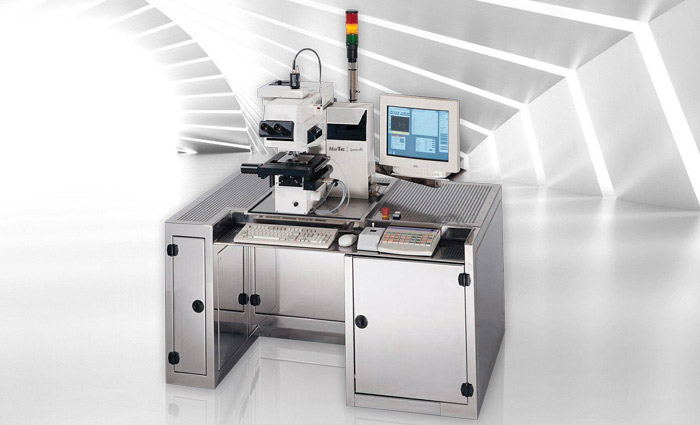
Spector M
Semi AutomaticShow details
Typical Application
Mask defect inspection
Features
Open tool architecture
Manual operator mask loading and unloading
Automatic inspection based on die-to-die comparison
Resolution as of 0,5 μ/pixel
Defect sizes as of 1 μm
Mask sizes up to 14’’

Spector A
Automatic with mask robot and mask carriersShow details
Typical Application
Mask defect inspection
Features
Open tool architecture
Robotor mask loading and unloading
Fully automatic mask inspection
Automatic inspection based on die-to-die comparison
Resolution as of 0,5 μ/pixel
Defect sizes as of 1 μm
Mask sizes up to 14’’

Spector
Automatic and fully enclosed with FFUShow details
Typical Application
Mask defect inspection
Key Features
Fully enclosed tool architecture
Robot handling of masks with up to 2 pod or cassette stations
Automatic inspection based on die-to-die comparison
Resolution of 0,5 μ/pixel
Defect sizes as of 1 μm
Mask sizes up to 14’’

